摘要:本文簡要介紹了直拉法單晶的過程控制的重要點和后期硅片常用的檢測方法及注意事項,,以達到產(chǎn)品從生產(chǎn)到出廠的連續(xù)質量控制環(huán)節(jié),,為客戶提供更高效,安全,高質量的服務,。
近幾年電子工業(yè)大規(guī)模發(fā)展,半導體集成電路被廣泛應用于各個工作領域,國家在政策和經(jīng)濟上給予了大力支持,,使得國內半導體材料企業(yè)如雨后春筍般大量成立。在短時間內使半導體市場供過于求,,各企業(yè)競爭激烈,,優(yōu)勝劣汰,不少企業(yè)不注重產(chǎn)品質量,,在追求量產(chǎn)的道路上越走越遠,,加速了企業(yè)的淘汰和破產(chǎn)。究其原因,,量產(chǎn)短時間內能夠使企業(yè)快速發(fā)展,,贏得市場和利潤,使得很多企業(yè)趨之若鶩,,進入了不良的競爭,,一味地追求產(chǎn)能,追求價格低廉,,薄利多銷,,最終在市場不僅僅滿足價格的基礎上,大批企業(yè)遭遇了困境,。而一些企業(yè)嚴把質量關,,改進生產(chǎn)工藝,調整產(chǎn)業(yè)結構,,使產(chǎn)品具有更大的價值,,領跑行業(yè)的前列。
2.1半導體的導電原理:
本征半導體就是純凈的晶體結構的半導體,,也就是單質半導體,。本征半導體的導電性能很差,當向其中摻雜微量的雜質離子時,,半導體的導電性會明顯變化,,就是雜質半導體。使半導體導電的因素有:
a雜質濃度,,濃度越高導電性越強
b溫度,,溫度越高導電性越強
c光照,、外場作用等影響
2.2直拉單晶生長法
直拉硅單晶(CZ/MCZ單晶),,這是單晶生長中最常用的一種方法,大多數(shù)企業(yè)采用的都是這種方法,廣泛應用于半導體集成電路、二極管,、太陽能,。
a裝料
明確裝料操作流程和方法,保證開爐效果,,避免開爐因裝料而導致的掛邊,,斷苞等不良情況,提高成晶率,。
套上一次性套袖,,戴上汗布手套和一次性手套,先用一些粒徑大于40mm的塊料鋪在石英鍋底(注意料的光滑面與石英坩堝接觸),,禁止使用碎料或粒徑小于30mm的料鋪底,,塊料較大的放在底料上面,用小塊料填縫補平,。大塊料必須放在石英坩堝2/3以下,面接觸,,2/3以上嚴禁放置直徑超過80mm塊料,,2/3以上塊料點接觸坩堝,防止掛料和架橋,。裝完的料盡量往中間靠攏,呈山型,,重心向內,,防止?jié)L落,。裝入一半原料時,將合金包打開,,放在料中間,,上面壓一些大塊料。放入導流筒,,確認料,、鍋、導流筒沒有接觸,。
b拉晶作業(yè)
規(guī)范細節(jié)操作,,避免異常事故,提高生產(chǎn)率,,杜絕和減少工傷事故,,實行安全生產(chǎn),確保產(chǎn)品質量滿足要求。
拆清爐前準備→取單晶→拆清爐→領料裝料(電阻率測算,,放入合金)→抽空→檢漏→化料→高溫烘烤→沾渣,,拉小頭→測電阻率→摻雜→穩(wěn)溫→引晶→放肩→轉肩保持→等徑→收尾→停爐→記錄停爐真空和漏率→爐體冷卻。
穩(wěn)溫后需矯正熱場溫度和液面溫度,,若熱場測量值低于700Unites,,需查看取光孔是否對正,取光玻璃是否發(fā)黑,。拉晶前需對籽晶進行預熱,,然后侵入液面過熱,籽晶充分熔接,,否則容易導致晶變,。引晶細徑應保持在2.5-3.5mm左右,并且細徑表面均勻,,長度大于需拉直單晶直徑的1.2倍,,平均拉速控制在200-300mm/hr。放肩如果溫度過高時,,可以手動給溫補,,一般降10-15SP/hr。轉肩時拉速控制在140-220mm/hr,防止拉速過高或者過低造成斷苞和轉肩失敗,。等徑階段需每100mm測量一次直徑,,防止直徑跑粗或跑細,注意直徑信號是否穩(wěn)定準確,,監(jiān)測點是否有偏離等現(xiàn)象,,保持過程中斷苞取段必須收尾2/3個直徑,斷苞回熔嚴禁將晶棒降入液面過多,,造成石英坩堝破裂,,漏硅及纜繩脫槽,每次下降50mm,。待完全熔完后,,再繼續(xù)下降晶體。收尾時一定要收尖,,長度不能呢個超過單晶直徑,,防止返位錯,造成不良,??梢允謩咏o溫補10-15sp/hr,防止溫補不夠而結晶粘上單晶,,造成生產(chǎn)事故,。
c復投工藝。
為了提高半導體單晶入檔率,增加產(chǎn)能,,實行復投工藝,。將復投料裝入復投器,中間預摻合金,,若單詞需要復投兩次,,將合金放入第二桶內。取夾頭,,連接復投器,。復投過程中要保證復投筒穩(wěn)定,不晃動,,防止晃動卡主,,造成事故。
3.1半導體材料中有兩種導電的載流子:一種是帶負電荷的載流子——電子,;另一種是帶正電荷的的載流子——空穴。由于某種原因激發(fā),,具有足夠能量的價電子掙脫共價鍵的束縛而成為自由電子,,自由電子的產(chǎn)生使共價鍵中留有一個空位置,稱為空穴,,在本征半導體中電子和空穴是成對出現(xiàn)的,當絕對溫度T=0K時所有的電子都被束縛,,不能成為自由電子所以本征半導體的導電能力極弱,,接近絕緣體。硅片分類:
a,、按照型號分:
?。?)N型半導體:多數(shù)載流子為電子的半導體。在硅(或鍺)的晶體中摻入少量5價雜質元素,,如磷,砷等,。在N型半導體中多子為自由電子,,少子為空穴
(2)P型半導體:多數(shù)載流子為空穴的半導體,。在硅(或鍺)的晶體中摻入少量3價雜質元素,,如硼、鎵等,。在P型半導體中多子為空穴,,少子為自由電子
b、按照晶向分:
(1)<111>(2)<100>(3)<110>
c,、按照電阻率分:
?。?)輕摻(2)重摻(3)太陽能級
3.2硅片測試影響因素:
a測試環(huán)境
凈化間內環(huán)境要求溫度:23℃±2℃濕度:≤65%
測試環(huán)境不符合條件應停止檢測
b高頻干擾源附近會引入虛假電流,,需電磁屏蔽
手機要遠離測試儀器,,所以不允許攜帶手機進入凈化間
c探針壓力
四探針探頭方式砝碼不允許私自調換,壓力過重硅片造成損傷甚至碎裂,,壓力過重檢測電阻率不真實,。
3.3硅片表面狀態(tài)
硅片表面無砂漿等沾污,硅片無線痕,、不平等不良,。
3.4硅片加工與不良處置流程
a硅片加工流程:
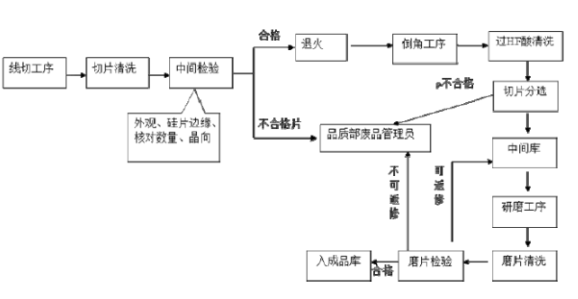
b硅片不良處置流程

不良品小條標注項目:單晶編號、直徑,、厚度,、電阻率、型號,、晶向,、偏離度、參考面類型,、客戶編碼,、合同號、不良原因,、不良數(shù)量,、檢驗員、檢驗日期14項
a ADE7200/8300自動檢測儀
檢測項目:硅片電阻率,、厚度,、TTV、WARP,、BOW,、型號等參數(shù)并具有數(shù)據(jù)存儲功能。厚度檢測最大量程:<1000微米(μm),;電阻率檢測最大量程:<200歐姆(Ω.cm)

b 四探針電阻率測試儀
檢測項目:硅片電阻率,。電阻率檢測最大量程:<100歐姆(Ω.cm),探頭上升最大高度:<2000微米(μm),在使用四探針時,,放完待測硅片后需將手移開后再按下降按鈕,,避免探針扎傷手指。校對方法:將樣片放在臺子上,,選擇與標準樣片電阻率合適的電流檔,,按四探針下降旋鈕,,使樣片待測點與四探針平穩(wěn)接觸,調節(jié)電流旋鈕,,使液晶屏顯示的值與標準樣片值一致,。反復校對三次后按下電流顯示按鈕,看一下電流值與標準樣片電流值是否一致,,如有誤差的話,,測量時將此誤差加減在待測硅片的測量電流上,然后再進行測量,。測試方法及步驟:打開電源開關,,預熱10分鐘測試標準樣片,校對儀器按所測硅片的厚度,,查表后調節(jié)電流,。放待測硅片,中心點所顯示數(shù)值即為該硅片電阻率.附錄:實測電阻率測量電流選擇對照表
電阻率測試取點法:(按顧客要求選擇取點方法)
九點法:中心一點,,距邊緣6mm處對稱4點,,此4點距中心點R/2處各一點
三點法:中心一點,距邊緣6mm處對稱兩點
五點法:中心一點,,距邊緣6mm處對稱兩點,,此兩點距中心點R/2處各一點
GB11073-89A方案:小面積十字型,測量六點:在硅片中心點測兩次,,在兩條垂直直徑的半徑中點(R/2)處各測量一點,。
GB11073-89B方案:大面積十字型,測量六點:在硅片中心點測兩次,,在兩條垂直直徑距硅片邊緣6mm處各測量一點,。
GB11073-89C方案:小面積及大面積十字型,測量十點:在硅片中心點測兩次,,在兩條垂直直徑的半徑中點(R/2)處各測量一點,,在兩條垂直直徑距硅片邊緣6mm處各測量一點。
GB11073-89C方案:一條直徑上的高分辨型:在硅片中心點以及中心與直徑兩端的距離之間,,以2mm間隔在盡可能多的位置上進行測量,。
如顧客有特殊要求,按特殊要求執(zhí)行,。
電阻率不均勻度計算方法:
ρ不均勻度=(ρmax-ρmin)/ρmin×100%
如顧客有特殊要求,,按特殊要求執(zhí)行。
c千分表
檢測項目:硅片厚度,。厚度檢測最大量程:<>
d型號儀
檢測項目:硅片導電類型
接通電源,指示燈亮,。接通熱筆加熱器電源,,熱筆溫度升高到60℃時,。檢查被測表面是否符合干燥,無油污,、砂粒,、噴砂均勻等要求,若不合要求,,表面應重新處理,。測量前,用已知P,、N型號樣塊檢查測量系統(tǒng)是否處于正常狀態(tài),。用冷熱法測量時,兩手分別拿冷熱筆,,并將筆緊壓在被測面上,,觀看P、N型號的指示燈來判斷型號,,測量時必須逐段交換冷熱筆位置,,以避免兩探筆下兩點間有不同的導電型號。操作完畢,,關閉熱筆加熱器電源和型號測試儀器電源
e硅片的直徑
測量工具:卡尺鋼板尺卡尺的校準:每次使用前必須對卡尺進行校對,。
校準方法:把卡尺推緊,使卡尺長腳一端的兩個內平面對齊貼緊,,不要有縫隙,,讀出卡尺準確數(shù)值。如卡尺有誤差,,在測量時一定要把誤差計算在內,。合格判定及檢測方法:目測合格時每段單晶抽測兩片;目測不合格時將最大和最小片挑出,,測量直徑,,如超出顧客要求公差范圍,視為此棵硅片直徑不合格,,退回車間返工,;硅片橢圓度在顧客要求的公差內為合格;參考面長度用鋼板尺測量,,長度在顧客要求的公差內為合格,。
5.1直徑:橫穿圓片表面,通過晶片中心點且不與參考面或圓周上其他基準區(qū)相交的直線長度,。
5.2崩邊:晶片邊緣或表面未貫穿晶片的局部缺損區(qū)域,,當崩邊在晶片邊緣產(chǎn)生時,其尺寸由徑向深度和周邊弦長給出,。
5.3倒角:晶片邊緣通過研磨或腐蝕整形加工成一定角度,,以消除晶片邊緣尖銳狀態(tài),,避免在后序加工中造成邊緣損傷。
5.4崩邊:晶片邊緣或表面未貫穿晶片的局部缺損區(qū)域,,當崩邊在晶片邊緣產(chǎn)生時,,其尺寸由徑向深度和周邊弦長給出。
5.5缺口:上下貫穿晶片邊緣的缺損,。
5.6亮點:硅片研磨或拋光后,,表面上殘留下來的一些孤立的機械損傷點,呈現(xiàn)為有可觀察到的孤立的小亮點,。
5.7裂紋:延伸到晶片表面,,可能貫穿,也可能不貫穿整個晶片厚度的解理或裂痕,。
5.8總厚度變化:在厚度掃描或一系列點的厚度測量中,,所測晶片的最大厚度與最小厚度的絕對差值。
5.9彎曲度:晶片中心面凹凸形變的一種度量,,它與晶片可能存在任何厚度變化無關,。彎曲度是晶片的一種體性質而不是表面特性。
5.10翹曲度:晶片中心面與基準面之間的最大和最小距離的差值,。翹曲度是晶片的一種體性質而不是表面特性,。
5.11平整度:晶片表面與基準平面之間最高點和最低點的差值,是一種表面特性,。
隨著半導體科學與技術的推廣,,為人類進步奠定了基石。單晶硅企業(yè)愈爭愈烈,,一些傳統(tǒng)的工藝手段已經(jīng)不能滿足市場的需要,,只有不斷開發(fā)新的工藝,不斷提高產(chǎn)品的質量,,才是企業(yè)生存的不二法門,。