摘 要: 采用不同的固封方式,,驗(yàn)證了航天用CQFP封裝器件在嚴(yán)苛力學(xué)條件下的抗振效果,并通過熱循環(huán)試驗(yàn)表明了不同膠黏劑由于熱膨脹系數(shù)的差異對(duì)焊點(diǎn)產(chǎn)生的影響,。力學(xué)試驗(yàn)表明,,使用灌封S113膠+四角點(diǎn)封環(huán)氧6101和底填,、四角點(diǎn)封均使用環(huán)氧55/9+引腳刷涂S113膠固封方式,兩者均能滿足力學(xué)加固的要求,,力學(xué)試驗(yàn)后器件和焊點(diǎn)均無損傷,。但是溫度循環(huán)試驗(yàn)表明,前者因熱失配更大,,對(duì)CQFP器件的焊點(diǎn)造成了較大的損傷,,而后者對(duì)焊點(diǎn)未造成明顯損傷。因此,,針對(duì)CQFP器件的加固,,應(yīng)根據(jù)產(chǎn)品不同的使用工況進(jìn)行區(qū)別對(duì)待。
關(guān)鍵詞: CQFP封裝器件,;環(huán)氧膠,;力學(xué),;熱循環(huán);顯微組織
CQFP器件具有高密度,、高可靠性以及優(yōu)良的電性能等諸多優(yōu)點(diǎn)在大規(guī)模集成電路中得到了廣泛應(yīng)用,,其常用的引腳數(shù)有256、240,、228,、208和172等,引腳間距一般為0.500 mm或0.635 mm,,質(zhì)量一般在8~20 g,,器件實(shí)物如圖1所示。CQFP器件的焊點(diǎn)在實(shí)際應(yīng)用中起著電氣連接和機(jī)械連接的雙重作用,,一旦焊點(diǎn)失效,,器件功能將無法實(shí)現(xiàn)。

影響CQFP器件焊點(diǎn)可靠性的因素除了焊點(diǎn)本身的質(zhì)量外,,還與器件的加固方式及器件所能承受的最大力學(xué)特性有密切關(guān)系,。調(diào)研國內(nèi)對(duì)CQFP器件的加固方式也各有不同,主要包括以下幾種[1-5]:1)在器件底部填充D04或GD414硅橡膠,;2)在器件四角點(diǎn)封GD414硅橡膠,;3)在器件四角點(diǎn)封E-44環(huán)氧膠;4)整體灌封QD231嵌段硅橡膠,;5)四角點(diǎn)封GD414,,灌封QD231嵌段硅橡膠;6)四角點(diǎn)封D04,,灌封QD231嵌段硅橡膠,;7)四角點(diǎn)封環(huán)氧6101,灌封聚氨酯S113膠等,。以上加固方式均能滿足一定條件下的產(chǎn)品使用性能,,但隨著航天電子產(chǎn)品對(duì)可靠性要求的不斷提升,特別是深空探測(cè)器所經(jīng)歷的大量級(jí)振動(dòng)和嚴(yán)酷的溫度變化環(huán)境,,以及高集成度的CQFP封裝的SIP模塊(質(zhì)量超過20 g)在航天電子產(chǎn)品中的應(yīng)用逐漸增多,,CQFP封裝器件如果加固不當(dāng),極易出現(xiàn)焊點(diǎn)開裂的問題,。因此,,有必要對(duì)現(xiàn)有CQFP封裝器件的加固效果做進(jìn)一步的驗(yàn)證和改進(jìn),以滿足復(fù)雜嚴(yán)苛空間環(huán)境對(duì)電子產(chǎn)品的需求,。
1 試驗(yàn)材料及過程
為了對(duì)比不同膠黏劑的加固效果,,本文以CQFP228器件為研究對(duì)象,使用環(huán)氧6101,、環(huán)氧55/9和聚氨酯S113作為加固材料,,其中環(huán)氧55/9中添加了適量滑石粉,,焊料使用Sn63Pb37焊錫絲,印制板2塊,,每塊焊接4個(gè)芯片,。具體試驗(yàn)方案見表1。
試驗(yàn)的操作流程如圖2所示,。
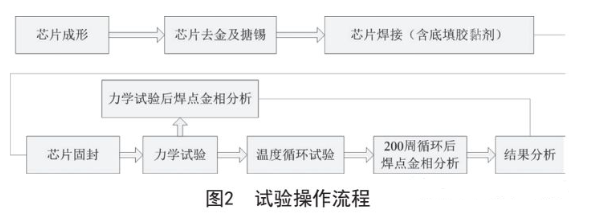
1.1 芯片焊接
使用專用成形設(shè)備對(duì)芯片引腳進(jìn)行成形處理,,成形后保證器件引腳共面性不大于0.1 mm[6],并在不低于30倍的放大鏡下檢查芯片本體及引線外觀應(yīng)無損傷,。為了防止焊接后焊點(diǎn)產(chǎn)生“金脆”現(xiàn)象,,需去除芯片引腳的鍍金層。使用專用去金錫鍋去除引腳鍍金層,,并在搪錫錫鍋內(nèi)對(duì)芯片引腳進(jìn)行二次搪錫處理,。操作過程中注意避免器件引腳變形影響共面性。檢查CQFP器件焊盤,,應(yīng)無阻焊覆蓋,,使用智能電烙鐵對(duì)印制板上需要焊接的CQFP器件焊盤進(jìn)行搪錫,搪錫后再使用吸錫繩將焊錫吸除干凈,,目視檢查處理后的焊盤應(yīng)光滑、明亮和平整,。
對(duì)于方案二中的芯片,,定位前需要先在芯片底部中心區(qū)域填充環(huán)氧55/9膠黏劑,填充大小為內(nèi)切圓直徑為D10~12 mm的正方形,。填充后實(shí)物如圖3所示,。
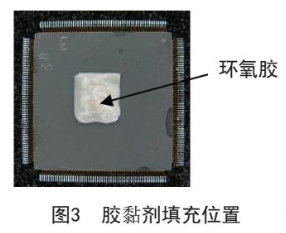
為保證焊接后器件引腳底部有一定高度的焊料填充,定位時(shí)對(duì)器件本體進(jìn)行抬高處理,。確保引腳和焊盤之間有0.08~0.10 mm的間隙,。器件本體抬高后,在10倍放大鏡下對(duì)器件引腿進(jìn)行對(duì)位,,使器件引腿和焊盤位置充分重合,。然后對(duì)器件進(jìn)行四角定位,定位后使用30倍放大鏡檢查器件引腳和焊盤的對(duì)中情況,。待芯片準(zhǔn)確定位后,,使用SP200智能電烙鐵對(duì)器件進(jìn)行焊接,完成焊接待焊點(diǎn)充分冷卻后,,使用異丙醇溶液對(duì)器件進(jìn)行刷洗,,用軟毛刷順器件引線方向從腳跟向腳尖移動(dòng)進(jìn)行刷洗。檢查焊點(diǎn)應(yīng)光滑明亮,、潤濕良好和無漏焊,,器件外觀和引腳無損傷,。
1.2 芯片固封
按照表1中的方案分別對(duì)A板和B板進(jìn)行固封。A板使用環(huán)氧6101對(duì)器件四角進(jìn)行點(diǎn)封,,室溫固化24 h后,,對(duì)器件底部灌封聚氨酯S113膠,并對(duì)器件抽真空以排除氣泡,,室溫固化48 h,。
B板使用環(huán)氧55/9對(duì)器件四角進(jìn)行點(diǎn)封,晾置2 h后,,在50 ℃烘箱內(nèi)烘烤4 h(或室溫固化24 h),,使環(huán)氧膠黏劑完全固化。然后對(duì)器件引腳刷涂少量聚氨酯S113膠,,并在50 ℃烘箱內(nèi)烘烤6~8 h完成固化,。
固封后產(chǎn)品實(shí)物如圖4所示。
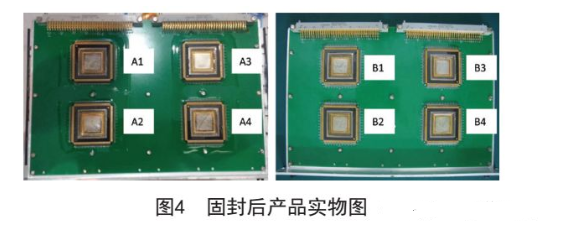
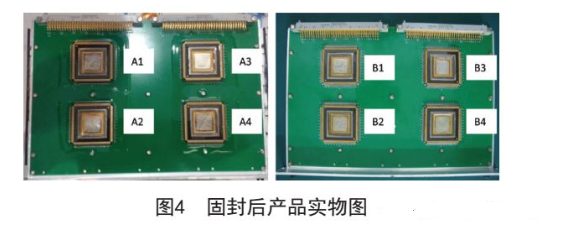
2 力學(xué)試驗(yàn)及分析
2.1 力學(xué)試驗(yàn)條件
將固封后的印制板裝入專用振動(dòng)工裝內(nèi),。選擇目前航天器型號(hào)中相對(duì)嚴(yán)苛的力學(xué)條件進(jìn)行試驗(yàn),,試驗(yàn)條件見表2。

2.2 力學(xué)試驗(yàn)后焊點(diǎn)金相分析
力學(xué)試驗(yàn)后使用放大倍數(shù)不低于30倍的三維光學(xué)顯微鏡檢查A,、B板焊點(diǎn)外觀,,均未發(fā)現(xiàn)焊點(diǎn)有明顯損傷現(xiàn)象。然后對(duì)編號(hào)為A1,、A2,、B1、B2的芯片進(jìn)行剖切,,每個(gè)芯片選取4個(gè)焊點(diǎn),,使用掃描電子顯微鏡觀察焊點(diǎn)內(nèi)部是否有裂紋產(chǎn)生,焊點(diǎn)顯微組織照片如圖5所示(部分),。通過金相分析結(jié)果可以看出,,對(duì)于兩種固封方案,力學(xué)振動(dòng)后,,焊點(diǎn)均無裂紋,,兩種固封方案對(duì)CQFP器件的加固均有明顯效果。焊點(diǎn)內(nèi)部無氣孔,,焊料和引腳之間以及焊料和焊盤之間形成了均勻連續(xù)的金屬間化合物層,。
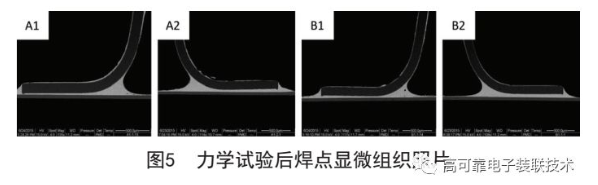
方案一中聚氨酯S113膠雖然是一種涂覆性材料,但經(jīng)過灌封后S113膠對(duì)CQFP器件形成了一種包裹的作用,,芯片底部的S113膠同時(shí)又起到了支撐器件的作用,,芯片四角的環(huán)氧6101由于粘接強(qiáng)度較大,對(duì)芯片也起到了一定的支撐作用,,在S113和環(huán)氧6101的共同作用下,,有效降低了振動(dòng)過程中焊點(diǎn)所受的應(yīng)力,,對(duì)焊點(diǎn)起到了保護(hù)作用。同理,,環(huán)氧55/9作為底部填充材料和四角點(diǎn)封材料,,其粘接強(qiáng)度大于S113膠和環(huán)氧6101,對(duì)芯片也起到了粘接和支撐的作用,,可以有效地保護(hù)焊點(diǎn)在振動(dòng)過程中不受損傷,。
3 熱循環(huán)試驗(yàn)及分析
3.1 熱循環(huán)試驗(yàn)條件
參照ECSS相關(guān)標(biāo)準(zhǔn),力學(xué)試驗(yàn)后對(duì)剩余的A3,、A4,、B3、B4器件進(jìn)行溫度循環(huán)試驗(yàn),,溫度循環(huán)條件設(shè)定溫度從-55~100 ℃,,200次取出檢驗(yàn),最大升降溫速率為10 ℃/min,,誤差±5 ℃,。在每個(gè)溫度極限下樣品的保溫時(shí)間為15 min。
3.2 熱循環(huán)試驗(yàn)后焊點(diǎn)金相分析
熱循環(huán)后取出芯片,,并使用放大倍數(shù)不低于30倍的三維光學(xué)顯微鏡檢查焊點(diǎn)外觀,,均未發(fā)現(xiàn)焊點(diǎn)有明顯損傷現(xiàn)象。然后對(duì)芯片進(jìn)行剖切,,每個(gè)芯片選取4個(gè)焊點(diǎn),,使用掃描電子顯微鏡觀察焊點(diǎn)內(nèi)部是否有裂紋產(chǎn)生,焊點(diǎn)顯微組織照片如圖6所示(部分),。
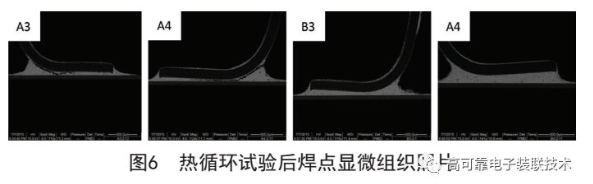
經(jīng)測(cè)量裂紋長度,采用方案一時(shí),,器件在經(jīng)歷熱循環(huán)試驗(yàn)后,,金相剖切的8個(gè)焊點(diǎn)中,5個(gè)焊點(diǎn)的內(nèi)部裂紋長度超過了25%,,不滿足ECSS標(biāo)準(zhǔn)的要求,。采用方案二時(shí),8個(gè)焊點(diǎn)的內(nèi)部均未發(fā)現(xiàn)明顯裂紋,。
方案一和方案二的最大區(qū)別在于固封的方式不同,,通過力學(xué)試驗(yàn)后的焊點(diǎn)金相分析,兩種固封方式均能經(jīng)受規(guī)定的力學(xué)試驗(yàn)考核,,但溫度循環(huán)試驗(yàn)后方案一的樣品不合格焊點(diǎn)比例占到了62.5%,,方案二的樣品焊點(diǎn)全部合格,這說明焊點(diǎn)開裂是發(fā)生在溫度循環(huán)過程中,,且不同的固封方式導(dǎo)致了試驗(yàn)結(jié)果的巨大差異,。在熱循環(huán)過程中,,由于材料熱膨脹系數(shù)的不同(見表3),固封膠,、金屬引腳及焊料之間會(huì)產(chǎn)生熱失配,,無論是灌封的S113膠還是四角點(diǎn)封的環(huán)氧6101,和環(huán)氧55-9加填料相比,,熱膨脹系數(shù)更大,,在溫度交變過程中,S113膠和環(huán)氧6101產(chǎn)生的變形也更大,,會(huì)對(duì)焊點(diǎn)施加較大的交變應(yīng)力,,可能會(huì)導(dǎo)致裂紋產(chǎn)生并擴(kuò)展。
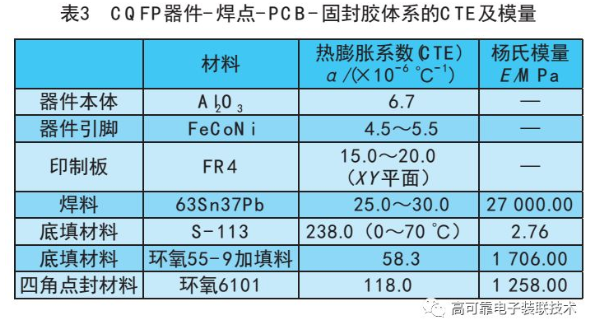
4 結(jié)論
針對(duì)航天用CQFP器件分別使用“灌封S113膠+四角點(diǎn)封環(huán)氧6101”和“底填,、四角點(diǎn)封均使用環(huán)氧55/9+引腳刷涂S113膠”兩種固封方式進(jìn)行了力學(xué)加固,。力學(xué)試驗(yàn)表明,兩者均能滿足力學(xué)加固的要求,,力學(xué)試驗(yàn)后器件和焊點(diǎn)均無損傷,。溫度循環(huán)試驗(yàn)表明,“灌封S113膠+四角點(diǎn)封環(huán)氧6101”的固封方式因熱失配更大,,對(duì)CQFP器件的焊點(diǎn)造成了更大的損傷,,而采用“底填、四角點(diǎn)封均使用環(huán)氧55/9,、引腳刷涂S113膠”的固封方式,,溫度循環(huán)試驗(yàn)后,焊點(diǎn)未發(fā)現(xiàn)有明顯損傷,。因此,,在實(shí)際產(chǎn)品的應(yīng)用中,可根據(jù)不同的工況選擇不同的加固方式,,建議如下:1)對(duì)于短期工作和溫度交變不大的,,可采用“灌封S113膠+四角點(diǎn)封環(huán)氧6101”的固封方式,以確保器件的抗力學(xué)效果,。2)對(duì)于長期工作和溫度交變比較大的,,可采用“底填和四角點(diǎn)封均使用環(huán)氧55/9,引腳刷涂S113膠”的固封方式,,以降低S113膠因熱失配大帶來的負(fù)面影響,。